Technical advantages of 3C-SiC for preparation of MOSFET.
Ⅰ International research has proven that 600-1200V MOS devices are feasible
Ⅱ High channel mobility 300cm2/V.s
Ⅲ The typical value of 4H-SiC is 10-100 cm2/V.s
Ⅳ Low interface state density,significantly improves device reliability
Ⅴ Low on-resistance
Ⅵ Ohmic electrode process
|
Items |
Standard |
|
|
Poly-type |
4H-p、3C-n |
|
|
Surface |
(0001) Si-face |
|
|
Off-orientation |
4deg-off [11-20] |
|
|
Conductivity |
n-type / p-type |
|
|
Dopant |
Nitrogen / Aluminum |
|
|
Carrier Concentration |
Range |
1E15 ~ 5E16 cm-3 |
|
Tolerance |
±15% |
|
|
Uniformity(s/mean) |
≤10% |
|
|
Epi thickness |
Range |
5 ~ 100 μm |
|
Tolerance |
±10% |
|
|
Uniformity(s/mean) |
≤4% |
|
|
Surface roughness |
≤ 2 nm |
|
Notes:
Measure points for Thickness and Carrier Concentration . Generally, the test method concludes 9 points (as shown in the figure), also the customer can assign the test method.

Ⅰ Carrier Concentration by Hg-CV.
Ⅱ Thickness by FTIR.
Ⅲ The roughness is tested by AFM,the scan size is 10×10μm2.
Ⅳ Better products can be customized.

3C-SiC interface state capture center entering conduction band, and the density of gate oxygen interface states formed by the interface state is significantly lower than that of 4H-SiC
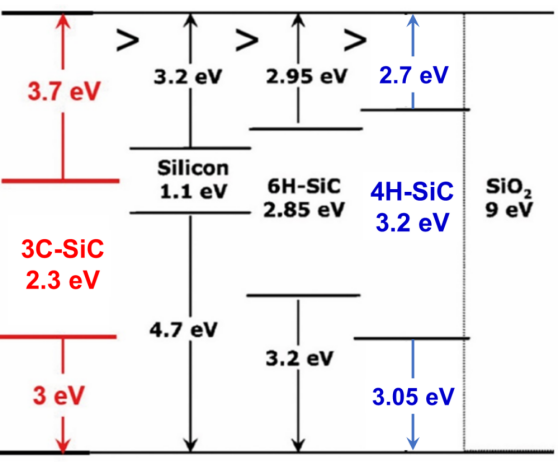
The conduction band energy level difference of 3C-SiC/SiO2 is significantly higher than that of 4H-SiC/SiO2. That is beneficial for improving the reliability of gate oxygen

